2006 – 2010
Dissertationen aus den Jahren 2006 – 2010
2010
| Name | Thema / Titel |
|---|
| D. Kunder |
3D Simulation des Zerstäubungsätzens mittels der Monte-Carlo MethodeDatum der Promotion: 16.12.2010 |
| C. Kampen |
Untersuchung von CMOS Architekturen mit Gatelängen kleiner 50 nm mittels numerischer SimulationenDatum der Promotion: 03.12.2010 |
| A. Fet |
Austrittsarbeitskontrolle für Metall/Hoch-E MOS StapelDatum der Promotion: 03.11.2010 |
| M. Grieb |
Charakterisierung von Metall-Oxid-Halbleiter-Strukturen auf der Silicium- und Kohlenstoffseite von 4H-SiliciumcarbidDatum der Promotion: 06.08.2010 |
| B. Eckardt |
Gleichspannungswandler hoher Leistungsdichte im Antriebsstrang von KraftfahrzeugenDatum der Promotion: 02.08.2010 |
| P. B. Meliorisz |
Simulation der NahfeldbelichtungDatum der Promotion: 14.07.2010 |
| M. Lemberger |
Chemische Gasphasenabscheidung von Metallsilicatschichten aus Einquellen-Ausgangsstoffen für Anwendungen in der MikroelektronikDatum der Promotion: 09.02.2010 Die gewählte Struktur mit gemischten Liganden zeigte einen vielversprechenden Kompromiss zwischen Flüchtigkeit und Stabilität der Ausgangsstoffe und auch deren CVD-Verhalten erwies sich geeignet. Die erzielten Schichten im Temperaturbereich 500 bis 600°C waren aufgrund einer bevorzugten Abspaltung des Siloxidliganden metallreich (d. h. Siliciumanteil bis etwa 20%). Eine signifikante Kohlenstoffkontamination (bis etwa 20 at.-%) aufgrund unvollständig dissoziierter Siloxidliganden erforderte eine Temperung in Sauerstoff bei Temperaturen größer 700°C. Diese Temperung verursachte neben der Eliminierung des Kohlenstoffs mit verbundener Ausheilung von Störstellen und Ladungen eine Kristallisation, aber auch einWachstum der Grenzflächenschicht zwischen Zirconium- bzw. Hafniumsilicat und Siliciumsubstrat. Dies beschränkt eine Skalierung zu kleinen effektiven Oxiddicken. Schichten einer Dicke von etwa 10 nm, die bei 900°C für 10 s in O2 getempert wurden, zeigten jedoch ein Optimum elektrischer Kenngrößen (z. B. effektive Dielektrizitätskonstante von etwa 12,5 bei einer Stromdichte kleiner 10-8 A/cm2 für elektrische Feldstärken gleich 1 MV/cm). In allen Schichten konnte zudem eine hohe Ladungsdichte (z. B. feste Isolatorladung bis etwa 1012 cm-2 bei Volumenladungsdichten bis etwa 8·1019 cm-3) beobachtet werden, welche die Stromtransportmechanismen (v. a. haftstellenbasierte POOLE-FRENKEL-Emission) als auch stressinduzierten Leckstrom als Indiz für eine Degradation begründet. Unterschiede konnten in Bezug auf die Energieniveaus der vorhandenen Haftstellen in Zirconium- bzw. Hafniumsilicat gezeigt werden. Diese, jeweils zwei Niveaus, liegen in Hafniumsilicat etwa 0,65 und 1,05 eV und in Zirconiumsilicat 0,95 und 1,5 eV unterhalb der Leitungsbandkante des Dielektrikums. Durch die Haftstellen wird auch auch der Ladungsaufbau während eines elektrischen Stress beeinflusst. Neben ternären Metallsilicaten wurden die Auswirkungen einer Beimischung von Titansilicat unterschiedlicher Anteile in Hafniumsilicat mit resultierenden quarternären Hafniumtitansilicaten auf elektrische Kenngrößen untersucht. Dabei konnte gezeigt werden, dass sich durch Beimischung die Dielektrizitätskonstante erhöhen lässt, ohne dass dabei die Stromdichte signifikant steigt oder der Stromtransportmechanismus geändert wird. Im Rahmen der Untersuchungen trifft dies auf ein Hf:Ti- Verhältniss bis etwa 50:50 zu. Eine Erhöhung der Dielektrizitätskonstanten geht jedoch zu Lasten von Ladungen im Dielektrikum aufgrund ungesättigter Bindungen. Weiterhin konnte gezeigt werden, dass in Abhängigkeit von der Stöchiometrie sowohl einWechsel im Stromtransportmechanismus von POOLE- FRENKEL-Emission in hafniumreichen Hafniumtitansilicaten hin zu phonenunterstütztem Tunneln (d. h. ab einem Hf:Ti-Verhältnis von etwa 30:70 über Phononen einer Energie etwa 20 meV) stattfindet als auch für den Übergangsbereich in Bezug auf die Spannungspolarität ein unsysmmetrischer Stromtransport auftritt. Beides ist in einer kontinuierlichen strukturellen Änderung von Hafniumtitansilicat mit steigendem Titangehalt begründet (z. B. Phasenseparation, von der Hafniumtitansilicat/Silicium- Grenzfläche beginnend). Im Weiteren konnte die Kompatibilität des CVD-Prozesses wie auch des Hafniumsilicat als Dielektrikum zu Germaniumscheiben nachgewiesen werden. In Gegenwart von Germanium konnte ein im Vergleich zu Siliciumsubstraten geändertes Abscheideverhalten der Ausgangschemie (d. h. verstärkte Abspaltung der Siloxidliganden) beobachtet werden, aufgrund dessen sich z. B. eine Stöchiometrie des Dielektrikum zu annähernd stöchiometrischem, kohlenstofffreiem Hafniumoxid mit einem Siliciumeinbau nur in der oberster Deckschicht bei Isolatordicken größer etwa 15 nm auf nitridiertem Germanium ergab. Für eine Nitridierung der Germaniumoberfläche ließen sich durchgängig positive Auswirkungen auf C(U)- als auch J(U)-Charakteristiken von MIS-Kondensatoren zeigen (d. h. Erhöhung der Dielektrizitätskonstanten auf maximal 18,6 bei gleichzeitiger Verringerung der Ladungsdichte wie Stromdichte) im Vergleich zu blanken Germaniumscheiben. Der Stromtransport wurde wiederum über POOLE-FRENKEL-Emission über Haftstellen einer Energie von etwa 0,5 eV beobachtet. |
| J. Hinz |
Abscheidung und Charakterisierung metallischer Gateelektroden für zukünftige CMOS-TechnologienDatum der Promotion: 18.01.2010 In dieser Arbeit wurde die Kombination eines Tantal- oder Niobnitrids und eines Hafnium-basierten Dielektrikums als Gatestapelersatz untersucht. Die hohe thermodynamische Stabilität dieser Übergangsmetallnitride wurde theoretisch nachgewiesen. Es konnte gezeigt werden, dass die Austrittsarbeit einer stabilen Metallelektrode auf einem SiO2- und einem HfO2-Dielektrikum innerhalb einer geringen Toleranz übereinstimmt und nur von der Phasen-Zusammensetzung der Elektrode abhängt. Folglich konnte die Austrittsarbeit durch die Senkung des Stickstoffgehaltes oder auch durch den Einbau von Kohlenstoff in das Metallnitrid erhöht werden. Die karbidischen Verbindungen wurden durch die spezifische Wahl des MOCVD-Precursors erhalten, die Herstellung der unterstöchiometrischen Metallnitride erfolgte in einem PEALD-Prozess. Dieser erzeugte sehr homogene, leitfähige Schichten mit hoher Dichte. Hiermit hergestellte MOS-Kondensatoren konnten so optimiert werden, dass die Temperaturstabilität des Gatestapels bei 900°C für 30 s erfüllt wurde. Für die PEALD-NbN- und die TaCxN1-x-Elektroden wurden weiterhin niedrige Ladungs- und Defektdichten, stabile Isolationseigenschaften des Gateoxids, sowie ein minimaler Zuwachs der effektiven Oxiddicke erreicht. Der mögliche Einsatz als metallische Elektrode in zukünftigen MOSFETs oder DRAM-Speichern wurde damit nachgewiesen. Fortschritte konnten auch in der Dickenbestimmung von metallischen Schichten mittels Spektralellipsometrie erreicht werden. Die erstellten optischen Modelle erlaubten eine automatisierte Auswertung der ellipsometrischen Messungen und die Bestimmung weiterer Schichteigenschaften. |
2009
| O. Klar |
Charakterisierung und Modellierung von Ladungseinfangmechanismen in dielektrischen SpeicherschichtenDatum der Promotion: 06.04.2009 Die Ladungseinfangmechanismen wurden im Rahmen der Arbeiten zur Promotion experimentell untersucht. Speziell für diese Untersuchungen wurde ein eigenes Charakterisierungsverfahren entwickelt, welches das Unterschwellenverhalten der Speicherzellen in verschiedenen Programmierzuständen analysiert. Im Vergleich zu bisher bekannten Methoden erhöht dieses Verfahren die Genauigkeit der Bestimmung von lateralen Ladungsverteilungen in der Speicherschicht. Mittels Untersuchungen von gateinduzierten Drainleckströmen konnten inhomogene Ladungsverteilungen der Speicherladung aufgrund der Injektion von Elektronen mittels Fowler-Nordheim-Tunneln nachgewiesen werden. Diese Inhomogenitäten können Auswirkungen auf die Zuverlässigkeit der Speicherzelle haben, insbesondere bei weiterer Skalierung. Die entwickelten Verfahren wurden außerdem zur Charakterisierung von Speicherzellen im Rahmen der Durchführung von Zyklentests verwendet. Zyklentests zeigen die Schädigungen im Bauelement durch mehrmaliges Beschreiben und Löschen der Speicherzelle. Die Auswirkungen der Schädigungen wurden außerdem durch Untersuchungen der Speicherhaltezeit bei unterschiedlichen Temperaturen bestimmt. Dabei wurde nachgewiesen, dass das Speicherhaltevermögen aufgrund des zunehmenden Ladungsverlustes deutlich sinkt. Weiter konnte gezeigt werden, dass lokalisiert eingebrachte Ladungspakete in einer häufig beschriebenen und gelöschten Zelle auseinander fließen. Dies hat wiederum negative Auswirkungen auf den zuverlässigen Betrieb der Speicherzelle im Zwei-Bit-Modus. Um die erläuterten Untersuchungen durchzuführen, wurde ein spezieller Messplatz entwickelt, der hohe Zyklenraten bietet, dabei aber einen hohen Grad an Flexibilität in den Charakterisierungsmöglichkeiten garantiert. Mit Hilfe des Aufbaus konnte der Verlauf von Zyklentests erstmals in dieser Genauigkeit charakterisiert werden. Zur Identifikation der jeweiligen Zustände einer Speicherzelle wurden Bauelementesimulationen durchgeführt. Das experimentell gefundene Verhalten der Speicherzellen konnte dabei durch die Simulationen vollständig nachgebildet werden. |
2008
| H. Schmitt |
Untersuchung der UV-Nanoimprint-Lithografie als Strukturierungsverfahren für elektronische BauelementeDatum der Promotion: 06.11.2008 |
| V. Lorentz |
Bidirektionale DC-Spannungswandlung für KleinleistungsanwendungenDatum der Promotion: 27.10.2008 |
| G. Roeder |
Entwicklung von Verfahren zur Kontrolle von Plasmaätzprozessen mittels in situ-Ellipsometrie und optischer EmissionsspektroskopieDatum der Promotion: 28.07.2008 |
| T. Erlbacher |
Schichten hoher Dielektrizitätskonstante für den Einsatz in ladungsbasierten nichtflüchtigen SpeicherzellenDatum der Promotion: 27.05.2008 |
2007
| T. Schnattinger |
Mesoskopische Simulation der Photolackbearbeitung in der optischen LithographieDatum der Promotion: 23.11.2007 In dieser Arbeit wurden neue Modelle für die mesoskopische (d.h. diskrete und stochastische) Simulation der Photolackstrukturierung in der optischen Lithographie entwickelt und implementiert. Es wurde bewiesen, dass eine Modellierung der Poissonverteilung der Photonen (sog. „shot noise“) nicht notwendig ist. Entgegen der in der Literatur verbreiteten Ansicht konnte damit gezeigt werden, dass die durchschnittlich bei der Belichtung absorbierte Photonenanzahl keinen unmittelbaren Einfluss auf die Linienbreitenschwankungen hat. Bei der Simulation des nachfolgenden Ausheizens nach der Belichtung konnten der Speicherbedarf und die Rechenzeit gegenüber dem Standardverfahren für mesoskopische Reaktions- und Diffusionssimulation verringert werden. Zur Simulation der anschließenden Photolackentwicklung wurde ein neuer Algorithmus entwickelt, der eine überlappungsfreie Darstellung der Polymere im Photolack mit kalibrierten Entwicklungsraten kombiniert. Damit konnte erstmals eine quantitative Übereinstimmung der mittleren Photolackprolabmessungen von mesoskopischen Modellen und etablieren makroskopischen Modellen bzw. experimentellen Daten erzielt werden. Die mit mesoskopischen Modellen simulierten Profildaten erfordern noch eine Nachbearbeitung, um eine automatische Auswertung zu ermöglichen. Dazu wurde ein effizienter Algorithmus entwickelt und implementiert um die Position der Oberfläche des entwickelten Photolacks zu bestimmen. Mit den neuen Modellen wurde der Einfluss von Prozess- und Photolackeigenschaften auf die Linienbreitenschwankungen untersucht. Dabei ergab sich eine sehr gute Übereinstimmung mit experimentellen Daten aus der Literatur. |
| M. Rommel |
Photostrom-Spektroskopie von Silicium im Volumen und an der Grenzfläche zu SiliciumdioxidDatum der Promotion: 28.09.2007 |
| M. Rambach |
Untersuchung von Ausheilverfahren für Aluminium-implantierte Schichten in 4H-SiliciumcarbidDatum der Promotion: 18.05.2007 |
2006
| M. Jank |
Entwicklung und Charakterisierung eines CMOS-Prozesses mit minimierter Anzahl an LithographieebenenDatum der Promotion: 05.12.2006 In dieser Arbeit wird erstmals ein CMOS-Prozess auf Bulk-Silicium-Ausgangsmaterial demonstriert, der mit nur drei Maskenebenen f�r die Bauelementeprozessierung beziehungsweise f�nf Maskenebenen bis zur ersten Metallebene durchgef�hrt werden kann. Hierf�r werden bekannte Methoden zur Einsparung von Lithographieebenen in CMOS-Prozessen zu einem neuartigen Prozess-Konzept weiterentwickelt, dessen kritische Aspekte herausgearbeitet und durch Experimente sowie Prozess- und Bauelementesimulationen eingehend untersucht. Ausgangspunkte f�r den neu entwickelten CMOS-Prozess sind ein Konzept zur selbstjustierten Hochenergie-Ionenimplantation beider Wannendotierungen �ber nur eine Photolackmaske und ein Konzept zur Definition der Wannen- und zugeh�rigen Source/Drain-Gebiete mit je einer Maskenebene pro Transistor-Leitungstyp. Durch Kombination dieser beiden Ans�tze kann die Trennung zwischen p- und n-Kanal-Transistoren w�hrend der Dotierung mit lediglich einer Lithographieebene vorgenommen werden. Als direkte Konsequenz aus dem vorgeschlagenen Dotierungsschema ergibt sich eine gegenseitige Beeinflussung der komplement�ren Source/Drain-Hochdosisimplantationen. In Anlehnung an den am IISB verf�gbaren CMOS-Prozess werden Experimente mit verschiedenen Energie/Dosis-Kombinationen f�r n- und p-Hochdosis-Implantationen durchgef�hrt und M�glichkeiten zur Optimierung aufgezeigt. Der entwickelte CMOS-Prozess nutzt die unterschiedlich gro�en lateralen Streuungen der tiefen Wannenimplantationen im Vergleich zu den flachen Source/Drain-Implantationen. Unter schmalen Lacks�ulen oder stegen in den ge�ffneten n-Wannenbereichen wird die n- Wanne fortgef�hrt und gleichzeitig eine Dotierung des n-Wannenkontakts w�hrend der p+- Hochdosis-Implantation verhindert. Komplement�r dazu entstehen unter schmalen L�chern oder Gr�ben in den von Lack bedeckten p-Wannen-Bereichen die p-Wannenkontakte, ohne dass die p-Wanne im Bereich des Kontakts unterbrochen wird. Untersuchungen mittels Prozess- und Bauelementesimulationen (Fig. 1) zeigen, dass die maximal zul�ssigen Dimensionen dieser Lackstrukturen in der vom LEB-CMOS-Prozess abgeleiteten Technologie realisiert werden k�nnen. Bei der Skalierung nimmt die maximal zul�ssige Dimension weniger stark ab als die minimale Strukturbreite, die Anforderungen entspannen sich. Zur selbstjustierten Maskierung der Source/Drain-Gebiete werden in dem vorgestellten CMOS-Prozess s�mtliche Dotierungen nach Fertigstellung der Bauelementestrukturen, insbesondere der Gateelektroden, eingebracht. Wannen- und Kanalimplantationen werden somit durch den bestehenden Gatestapel hindurch ausgef�hrt. Experimente zum Einfluss der Implantation durch den Gatestapel auf Qualit�t und elektrische Eigenschaften der Gateoxide zeigen, dass deren Sch�digung mit der Energieabgabe in Kernst��e im Bereich des Dielektrikums korreliert und durch Temperaturbehandlung teilweise ausgeheilt werden kann. Andererseits wird durch die Implantation die Dichte der Schwachstellen, an denen sich w�hrend elektrischer Belastung elektrisch aktive Defekte ausbilden k�nnen, reduziert. Trotzdem zeigen mit h�heren Dosen durchimplantierte Gateoxide aufgrund der h�heren initialen Defektdichten geringere Ausfallzeiten beziehungsweise Durchbruchsladungen. Mit abnehmender Oxiddicke wirkt sich die Implantation durch den Gatestapel weniger stark auf die Gateoxid- Zuverl�ssigkeit aus. Mit den durchgef�hrten Untersuchungen wird in Anlehnung an den am IISB durchgef�hrten CMOS-Prozess die Umsetzbarkeit des entwickelten Konzepts demonstriert und zudem die Skalierbarkeit zu geringeren minimalen Strukturbreiten nachgewiesen. 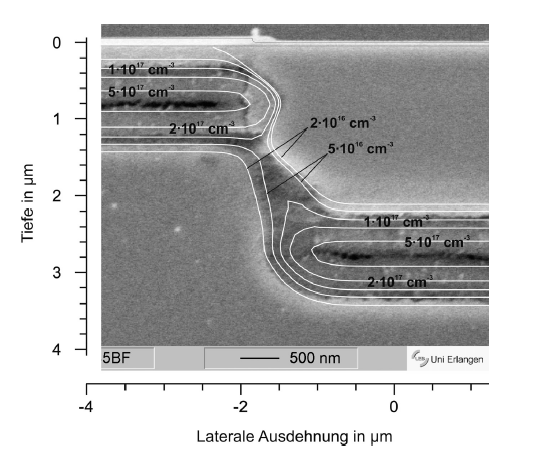 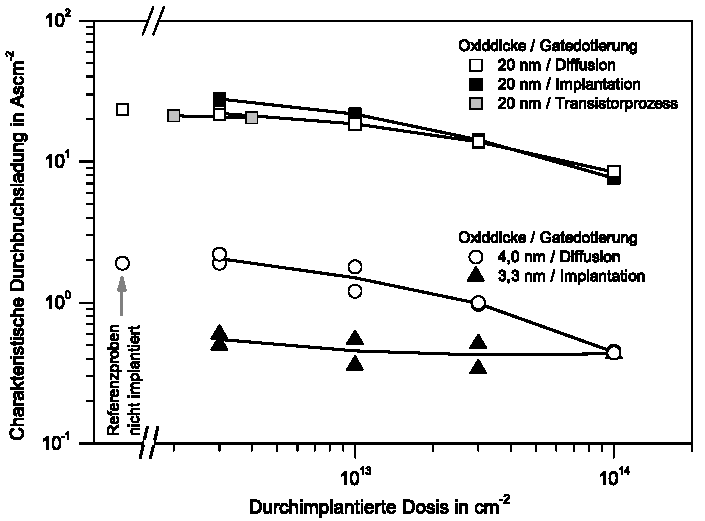
|
| S. Kistler |
Dreidimensionale Topographiesimulation der ionisierten Metallplasma-Abscheidung in der HalbleitertechnologieDatum der Promotion: 31.07.2006 |
| B. Tollkühn |
Neue Methoden zur automatischen Kalibrierung von Modellparametern für die Simulation optischer LithographieprozesseDatum der Promotion: 05.05.2006 |
| T. Dirnecker |
Untersuchung von Aufladungseffekten bei der IonenimplantationDatum der Promotion: 05.05.2006 |
